Samsung разрабатывает технологию упаковки чипов в 3D-TSV с 12 слоями
Компания Samsung Electronics Co., Ltd., мировой лидер в области передовых полупроводниковых технологий, объявила о разработке первой в отрасли 12-слойной технологии 3D-TSV (Through Silicon Via). Новая инновация считается одной из самых сложных технологий упаковки для массового производства высокопроизводительных чипов, поскольку она требует точности для вертикального соединения 12 микросхем DRAM через трехмерную конфигурацию из более чем 60000 отверстий TSV.
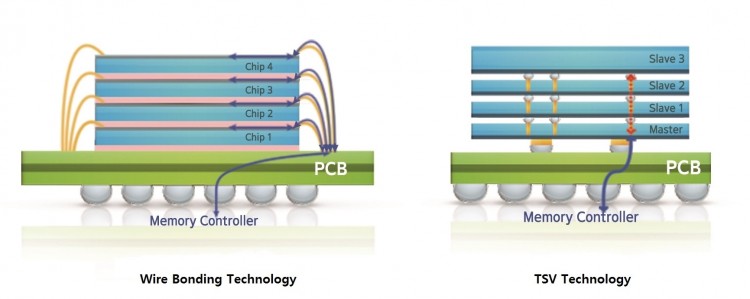
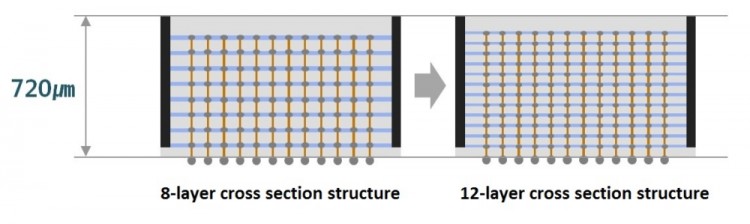
Ян Непомнящий выиграл первый в мире шахматный сеанс на склад…
Гроссмейстер Ян Непомнящий провёл первый в мире сеанс одновременной игры в шахматы на складных смартфонах…
Гроссмейстер Ян Непомнящий провёл первый в мире сеанс одновременной игры в шахматы на складных смартфонах…
Как выстроить стратегию информационной безопасности в компан…
Вы когда‑нибудь задумывались, что стоит между вашим бизнесом и катастрофой? В мире, где кибератаки слу…
Вы когда‑нибудь задумывались, что стоит между вашим бизнесом и катастрофой? В мире, где кибератаки слу…
Dreame на CES 2026 получила 50 наград…
Dreame Technology провела свою крупнейшую презентацию на выставке Consumer Electronics Show (CES) 2026. Г…
Dreame Technology провела свою крупнейшую презентацию на выставке Consumer Electronics Show (CES) 2026. Г…


