NVIDIA тестирует новую технологию упаковки чипов
Согласно последним утечкам, NVIDIA рассматривает возможность перехода на новый тип упаковки Chip-on-Wafer-on-Platform, который, как предполагается, будет использоваться в её следующем поколении графических процессоров Rubin. До сих пор индустрией ИИ и HPC активно применялась технология Chip-on-Wafer-on-Substrate — проверенное временем решение, впервые появившееся почти 14 лет назад. Именно CoWoS сегодня используется в передовых чипах от NVIDIA и AMD. У этой упаковки есть множество плюсов — зрелая экосистема поставщиков, отлаженные процессы производства и высокий уровень стабильности. Однако теперь похоже, что глобальные игроки на рынке ИИ ищут новые подходы — и NVIDIA одной из первых делает шаг вперёд.
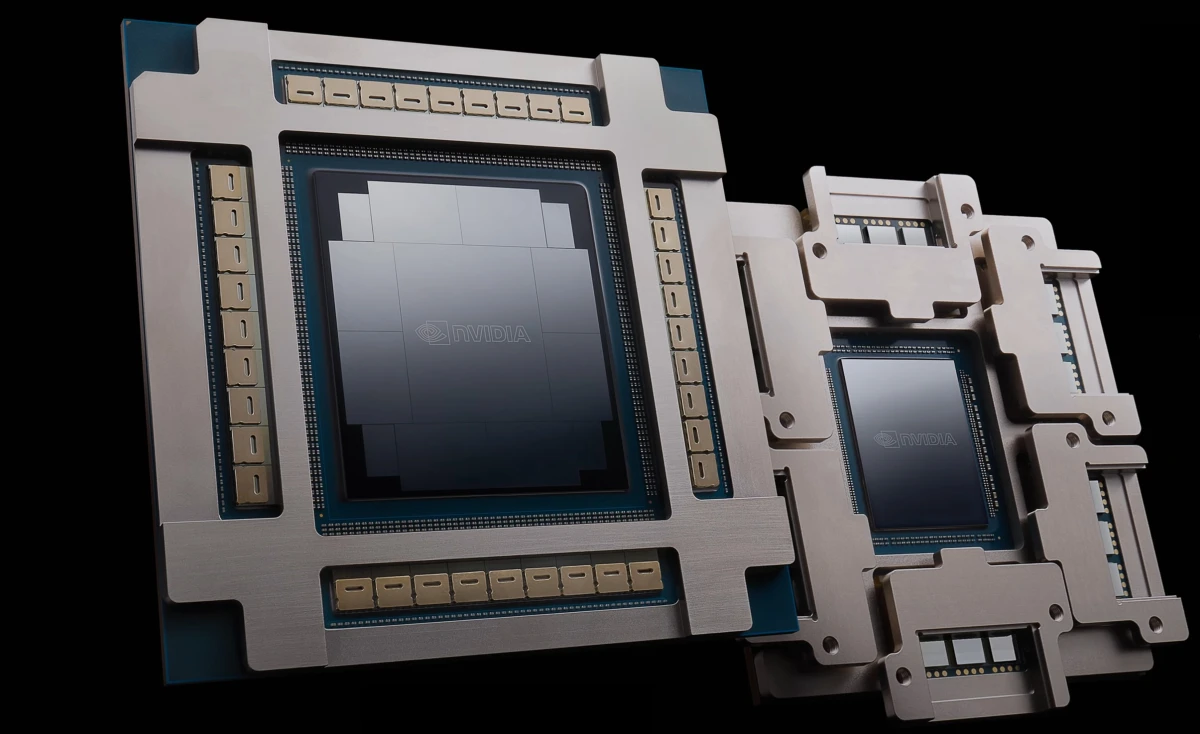
Intel анонсировала графику Xe Next для ИИ…
Компания Intel вновь подтвердила свою дорожную карту по графическим архитектурам следующего поколения, не…
Компания Intel вновь подтвердила свою дорожную карту по графическим архитектурам следующего поколения, не…
NVIDIA ищет инженера для улучшения Linux…
NVIDIA опубликовала сразу несколько вакансий, которые дают представление о планах компании в сфере игрово…
NVIDIA опубликовала сразу несколько вакансий, которые дают представление о планах компании в сфере игрово…
NVIDIA выпустила технологию DLSS 4.5…
Компания NVIDIA сегодня выпустила крупное обновление своей технологии DLSS, добавив новые режимы генераци…
Компания NVIDIA сегодня выпустила крупное обновление своей технологии DLSS, добавив новые режимы генераци…
Представлена видеокарта Intel Arc Pro B70…
Компания Intel пополнила ассортимент профессиональных видеокарт моделями Arc Pro B70 и Arc Pro B65, котор…
Компания Intel пополнила ассортимент профессиональных видеокарт моделями Arc Pro B70 и Arc Pro B65, котор…
MSI GeForce RTX 5090 Lightning Z треснула под разгоном…
MSI активно демонстрировала GeForce RTX 5090 Lightning Z на выставке CES 2026, где в презентационных мате…
MSI активно демонстрировала GeForce RTX 5090 Lightning Z на выставке CES 2026, где в презентационных мате…
NVIDIA RTX 5080 стала самой популярной видеокартой…
Новая стратегия продаж видеокарт привела к резкому изменению популярности отдельных моделей, и свежая ста…
Новая стратегия продаж видеокарт привела к резкому изменению популярности отдельных моделей, и свежая ста…
NVIDIA готовит к релизу новую версию GeForce RTX 5050…
NVIDIA, по информации инсайдеров, готовит обновлённую версию видеокарты GeForce RTX 5050, которая получит…
NVIDIA, по информации инсайдеров, готовит обновлённую версию видеокарты GeForce RTX 5050, которая получит…
Samsung будет выпускать новую память в два раза чаще…
Компания Samsung собирается ускорить выпуск новых поколений памяти HBM и перейти на ежегодный цикл обновл…
Компания Samsung собирается ускорить выпуск новых поколений памяти HBM и перейти на ежегодный цикл обновл…


